AI算力下一戰「沒台灣不行」! 專家直指「1產業」:是瓶頸也是決勝點

AI算力擴張的瓶頸已從晶圓代工轉向「先進封裝」。當3奈米晶片若無CoWoS技術便只是半成品,這項關鍵工序正成為決定AI晶片能否量產與交付的戰略物資,更是台積電、日月光與英特爾在算力競賽中的決勝點。
★【理財達人秀】台積狂賺 漲破天價 複製送分題 還有便宜撿 ★
先進封裝從後段工序躍升系統核心
根據《CNBC》報導,目前市場焦點多集中在晶圓代工,但實際上所有驅動AI的晶片,最終都必須透過精密的封裝技術才能與外部系統互動。具有多年操盤經驗的經理人沈萬鈞在臉書發文表示,AI晶片的競爭早就不是單顆晶片的競爭,而是整個封裝系統的競爭。不論是GPU、CPU或ASIC,最後都必須將邏輯晶片、HBM與高速I/O整合成一個高頻寬、低延遲的完整模組。沈萬鈞直言,先進製程負責把算力做出來,但唯有先進封裝才能把算力變成真正的產品,沒有CoWoS與高密度互連能力,再好的製程都只是半成品。
產能極限引發供應鏈結構性改變
目前先進封裝產能高度集中在亞洲且已瀕臨極限。台積電曾對外表示,CoWoS需求呈高速成長,即便晶片在美國生產,仍需送回台灣完成封裝。沈萬鈞指出,封裝廠的角色已從單純組裝轉變為決定晶片效能的核心;當資料搬運與散熱等挑戰集中在封裝層級,封裝端若不提早投入資本支出,將成為整個供應鏈的「choke point」(瓶頸點)。這也是為何台積電的CoWoS產能被市場視為稀缺資源,而非一般的擴產議題。
日月光由封測轉向高階協力
在產能吃緊的背景下,日月光的產業位置愈發重要。沈萬鈞認為,市場過去以傳統循環框架看待日月光,但現在外包已成為供應鏈重新分工的一環。根據《路透社》2月報導,日月光預估2026年先進封裝業務規模將翻倍至32億美元,台媒也引述公司說法指出LEAP業務將至少翻倍。隨著NVIDIA、Google及AMD持續提高外包比例,日月光正從傳統封測廠轉型為高階封裝產能協力者,其技術與客戶層級的提升,帶動了法人對其本益比框架的重新評價。
地緣政治壓力與英特爾的戰略轉機
先進封裝已升級為地緣政治問題。《CNBC》指出,若關鍵晶片仍需跨洲運回亞洲封裝,美國的供應鏈便無法達成閉環,這涉及交期與戰略自主。儘管英特爾在代工端仍待證明,但在先進封裝領域卡位較早。報導提到,英特爾已吸引亞馬遜、思科,甚至是馬斯克的客製化晶片需求。對於英特爾而言,這不只是營收增長,更是在AI基礎設施供應鏈中保住戰略存在感的機會。
▼ 翻攝自萬鈞法人視野 WJ Capital Perspective臉書
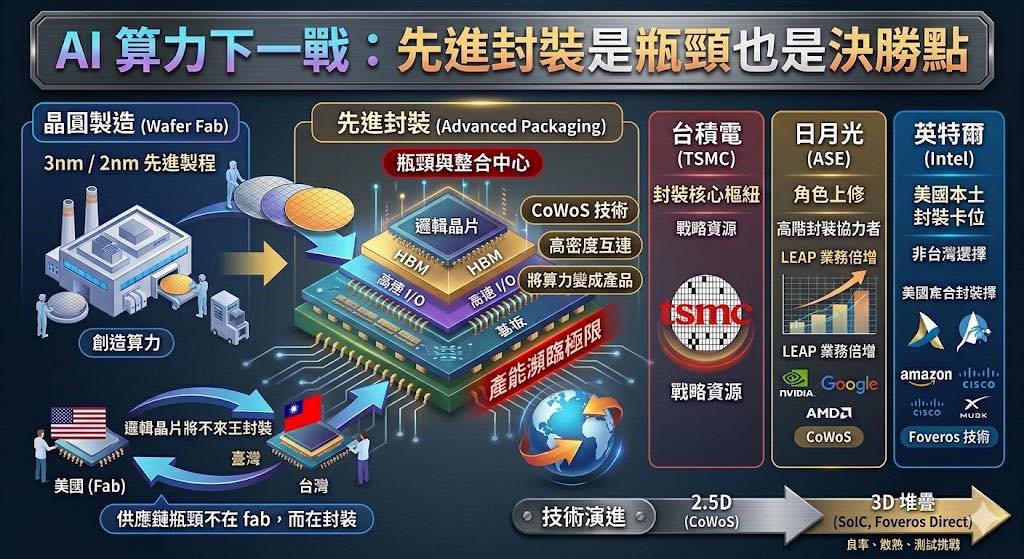
邁向3D堆疊的下一輪算力競賽
展望長線,目前的CoWoS技術僅是中段戰。沈萬鈞分析,未來技術將從2.5D走向更高密度的3D堆疊與混合鍵合(hybrid bonding),如台積電SoIC與英特爾Foveros Direct,讓晶片互連更短、功耗更低。封裝技術曲線仍在攀升,下一輪競爭將不再是誰先擴充CoWoS,而是誰能在3D堆疊時代維持良率、散熱與量產能力。AI算力的底層拼搏,最終將取決於誰能掌握封裝與供應鏈整合的完整能力。
(封面示意圖/AI生成)
【往下看更多】
►33檔有價證券遭列注意股! 台積電也入列 理由曝光
►曾經被鴻海甩很遠! 謝金河點名「這檔股」:低調的神山在崛起
►187家賺逾1股本! 謝金河點名「2產業」:獲利會很嚇人
【熱門排行榜】
►錢是拚命賺來的! 嗆兒「別想輕易拿」79歲老父下場超悲淒
►幫帶孫「1年噴50萬」壓力大! 女兒一句話 6旬夫婦心寒了
►苗栗辦徵才釋1600職缺! 欣興、京元電都來了 「這間」光起薪就有10萬



